硬X線領域のGISAXS測定
GISAXSによるキャップされた半導体ナノドットの構造解析
Si基板など、ほぼ理想的に平坦な表面に成長させたナノ構造薄膜に対し、全反射臨界角αcの2倍程度以下の入射角でX線を入射すると、表面ごく近傍のナノ構造を反映した散漫散乱(小角散乱)強度が観察される。この手法を利用すると、キャップ層によって被覆されたナノドットの形状やサイズなどを膜を破壊せず評価することができる。この手法をGrazingIncidenceSmall-angle X-ray Scattering(GISAXS)と呼ぶ。図1はSi基板上にMBE成長したGeナノドットをSiで被覆した構造に対してGISAXS測定を行った結果である{H.Okuda et al., Appl.Phys.Lett. 2002)。上下は基板垂直方向、左右は基板面内方向を反映しており、更に基板面内回転により図2のように異方性があるナノドットの形状を評価することができる。具体的な解析には図3のようにBorn近似でナノドットの形状サイズまで解析可能な領域と、動力学的な効果を取り込むシミュレーションが必要な領域がある(H.Okuda et al., J.Phys. Cond. Matt. 2010)。
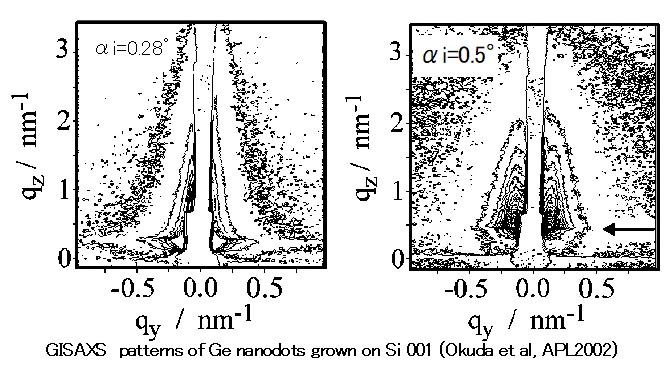
図1 Si cap/Ge nanodots / Si sub のGISAXS
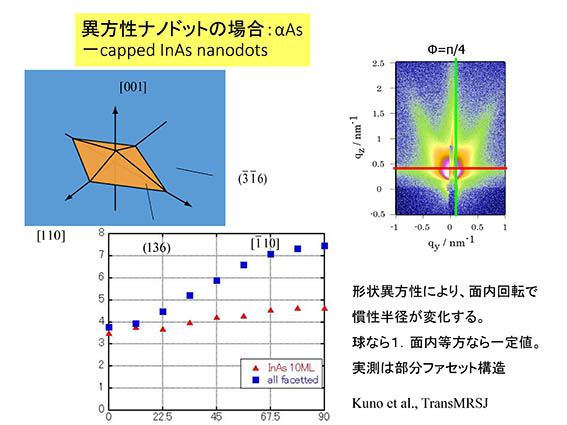

Tender X-rays領域でのGISAXS測定解析
GISAXSによるブロック共重合体薄膜の深さ分解構造解析
半導体基板の上にスピンキャストしたブロック共重合体薄膜のミクロ相分離構造は、自己形成によるテンプレートへの応用の検討などの観点から興味を持たれている。GISAXS法による散乱強度解析はミクロ相分離構造の基板面内、面垂直方向の構造を調べることができるため有用であるが、図4のように通常の波長(CuKαなど)のX線は臨界角近傍で急激にX線の侵入深さが増加するため、入射角を微調整して深さ分解測定をすることが難しい。我々はTenderX線と呼ばれるより長波長のX線でのGISAXS測定を実現し、深さ分解測定が可能であることを示した。図はSiのK吸収端近傍の波長でのGISAXSにより、SEBSのPS配列秩序が表面で構造緩和していることを示している(H.Okuda et al., J.Appl.Cryst.44(2011)380)。また、Si吸収端の異常分散効果を利用するとSiの屈折率を高分子膜の屈折率とほぼ一致させることができ、界面反射による散漫散乱が消失することを確認した。(J.Appl.Cryst.2012) Pの吸収端ではリン脂質膜構造のAGISAXSの試験を行っています。
